5G 通訊對5G線路板的技術要求
5G通訊在峰值速率、頻譜效率、時延等方面都發生了重大變化,電路板IC高度集成、大功率,單位面積上連接更多的元件數量,采用高密互聯設計,這給PCB和覆銅板材料提出了新的要求,本文重點介紹5G通訊對PCB及高速覆銅板技術要求。
電子通訊產品發展經歷了 1G、2G、3G、4G等幾個階段,目前正邁向第 5 代通訊產品階 段,作為第5代電子通訊,與 4G 相比,5G 在峰值速率、頻譜效率、時延等方面都發生了重 大變化,這給 PCB 和覆銅板材料提出了新的要求,
5G線路板5G 關鍵技術指標分析
5G產品將給大家帶來無限美好的移動互聯憧憬和體驗,從技術上來講,需要面對很多 挑戰,通過解決這些問題,必將帶來很多技術上的突破和提升。
在5G 時代,會有大量MIMO天線應用,在Massive MIMO 天線中,由于天線通道數量 的增加,每個天線通道在功率放大器中所對應的通道數也會相應增加,而這一變化會導致功率放大器的整體功率增加,從而需要功率放大器具備更高的功率效率,而作為提升功率效率的辦法之一,如何降低承載功率放大器的PCB 板材的損耗、提升PCB 板材的導熱率變得尤為重要。
另外,MassiveMIMO 天線中輻射單元數量增加,要求PCB 板材的硬度更高,以提供更好的支撐效果,并且電路的復雜度增加,較傳統雙面 PCB 天線而言,多層板天線應用會越來越多。
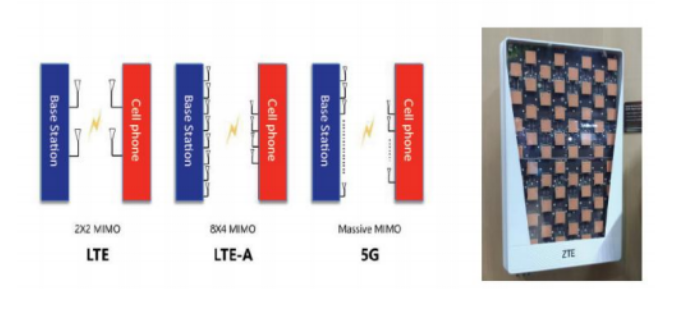
5G PCB 技術要求和技術難點
2-1 5G 通訊對 PCB 技術要求
隨著通訊產品體積小型化、容量反而增加的趨勢下,嚴重擠壓了產品前端的設計空間, 為了緩解這種設計壓力,通訊芯片廠商只有選擇研發更高速率的IC 產品,以滿足大容量、小體積的產品需求。然而速率增加后對于信號完整性工程師的壓力并未緩解反而加重,高速率產品可以使用更少的走線來實現,但速率的增加直接導致信號質量的嚴要求,且裕量越來越少。在10Gbps 信號下,信號的UI 可以達到100ps 的位寬,但在25Gbps 信號下,信號的位寬只有40ps,這就意味著在通道的每一個環節都要進行優化設計來爭取每一個ps 的裕量。
上圖是一條典型的高速系統全鏈路示意圖,從Driver IC 的封裝開始到Receiver IC 的封裝 結束,這其中包含IC封裝設計、子卡1PCB設計、背板PCB 設計、子卡2PCB設計。對于高速率信號,需要保證主板PCB的成功設計和加工才能保證整條通道信號質量。
5G通訊,作為第五代移動通訊產品,應用了很多新的技術,但無論如何都離不開PCB這個載體,對于PCB的要求越來越嚴苛,尤其是對于PCB基板材料、加工工藝、表面處理等提出非常高的要求。
5G通訊產品工作頻率不斷攀升,對印制板制作工藝帶來新要求,毫米波PCB通常是多層結構,微帶線和接地共面波導電路通常位于多層結構的最外層。毫米波在整個微波領域中屬于極高頻率(EHF)范圍,頻率越高,要求的電路尺寸精度要越高。 2.1.1 5G與4G 對PCB工藝能力要求對比

2.1.2 外觀控制要求:關鍵區域微帶線不允許出現凹坑劃傷類缺陷,因為高頻PCB的線路傳送的不是電流,而是高頻電脈沖信號,高頻導線上的凹坑、缺口、針孔等缺陷會影響 傳輸,任何這類小缺陷都是不允許的。
2.1.3 控制微帶天線拐角:為改善天線的增益、方向與駐波;避免諧振頻率往高頻偏, 提高天線設計的裕量,需要對微帶天線貼片拐角(Corner sharpness control)進行嚴控(EA),如 ≤20um、30um 等。
2.1.4 對于單通道 112G 高速產品,就要求 PCB 覆銅板材料具有較低的 Dk 和 Df,需要 新型樹脂、玻璃布及銅箔技術,要求 PCB 工藝背鉆精度更高,厚度公差控制更加嚴格,孔徑更小等。
2.1.5 HDI 高密技術應用:5G 時代產品對于 PCB 技術需求,包含二階 HDI 技術應用, 多次層壓技術,不對稱設計,0.15mm 微小孔,0.20mm 高密孔壁間距、不同體系材料混壓等。
2-2 5G 通訊 PCB 技術難點
5G芯片要求PCB 孔間距更小,最小孔壁間距達 0.20mm,最小孔徑 0.15mm,如此高密 布局對CCL 材料和 PCB 加工工藝都帶來巨大挑戰,如 CAF 問題,受熱孔間裂紋問題等。
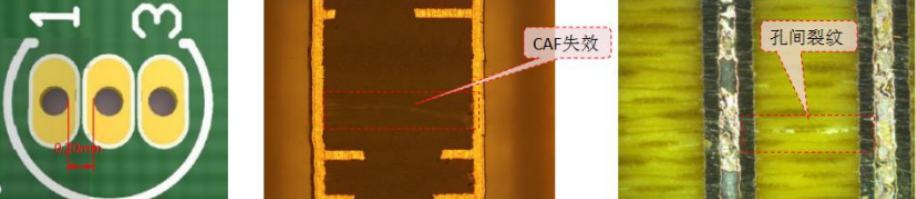
0.15mm 微小孔徑,最大縱橫比超過 20:1,如何防止鉆孔時斷針問題,如何提升 PCB 電 鍍縱橫比能力、防止孔壁無銅問題等,是目前 PCB 工藝急需解決的難題。

2-3 焊盤起翹
高速高頻PCB 為減少信號損耗,希望采用高速材料,并且孔環盡可能小,從孔環5.0mil 減小到3.0mil,但高速材料銅箔與樹脂結合力比常規FR4 材料要低,再使用小孔環,PCB 在經過回流或波峰焊時,由于熱應力沖擊,就發生焊盤起翹或表層PP 樹脂開裂缺陷,見下圖2-5。
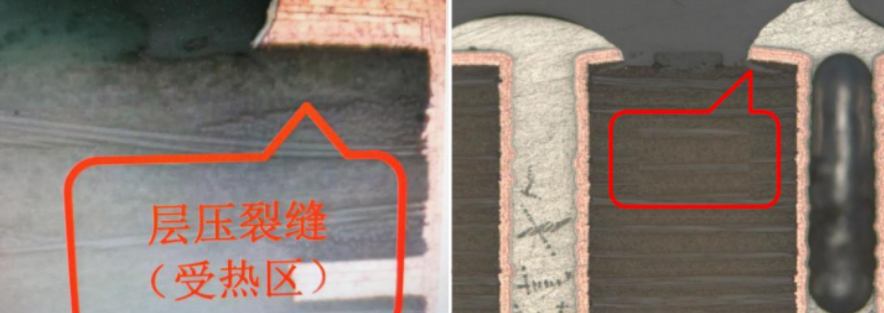
解決方案:高速發展是趨勢,孔環會越來越小,為減少焊盤起翹或 PP 層開裂缺陷,需 要在樹脂流動性和壓合工藝參數上進行工藝優化。
電路板廠講5G時代為電路板行業帶來了前所未有的機遇與挑戰。我們深知技術創新和工藝優化的重要性。未來,我們將繼續深耕高頻高速、高密度集成和高效散熱等技術領域,為5G設備提供高性能、高可靠性的電路板解決方案,助力5G技術的普及與應用,推動全球通信產業的持續發展。
ps:部分圖片來源于網絡,如有侵權,請聯系我們刪除
推薦深聯新聞
- 深聯電路榮膺2024年度“綠色制造與環保優秀企業”稱號
- 珠海深聯招聘專場,它來啦!
- 電池 FPC:電子設備供電連接的柔性基石
- 當 PCB 廠遇上 AI:是挑戰,還是開啟 “智能電路” 新賽道的鑰匙?
- 解碼線路板廠精密工藝:如何將基板雕琢成電子設備 “心臟”?
- 探秘汽車智能座艙線路板:復雜電路如何適配多變需求?
- 5G 時代,HDI 面臨哪些關鍵挑戰與發展機遇?
- 手機無線充軟板,如何為便捷充電 “搭橋鋪路”?
- 汽車激光雷達線路板為何需要耐極端溫度?普通 PCB 為何無法替代?
- PI 基材為何仍是柔性電路板的主流選擇??




總共 - 條評論【我要評論】