前言HDI是什么? HDI(High Density Interconnect) 全稱高密度互連板,是一種線分布密度高的高密度電路板,在現代電子設備中扮演著至關重要的角色。
它具有輕薄、線路密度高、有利于先進構裝技術的使用、電氣特性與信號更佳、改善射頻干擾/電磁波干擾/靜電釋放、傳輸路徑短等優點。
因此在手機、平板電腦、筆記本電腦、醫療設備和通信設備等領域得到了廣泛應用。
HDI技術的出現推動了PCB行業的發展,使得更密集的BGA(Ball Grid Array,球柵陣列)、QFP(Quad Flat Package,四邊扁平封裝)等元器件可以在HDI板上更緊密地排列。
據線路板廠小編所知,它同時也與芯片技術的提高相互推動。隨著設計工程師們廣泛采用0.5PITCH的BGA芯片,BGA的焊角也從中心挖空或中心接地的形式逐漸變為中心有信號輸入輸出需要走線的形式。
其利用了激光鉆孔技術,打破了傳統機械鉆孔的限制,這是HDI技術的一大突破。傳統PCB的機械鉆孔受到鉆刀影響,當孔徑達到0.15mm時,成本顯著上升,且難以進一步改進。
而HDI板的鉆孔孔徑一般在3-5mil(0.076-0.127mm)之間,線路寬度一般為3-4mil(0.076-0.10mm),通過這種方式,焊盤的尺寸可以大幅度減小,從而在單位面積內實現更多線路的分布,實現了高密度互連。
簡化HDI板的定義如下:
孔徑需小于等于6mil(1 mil為1/1000英寸)
孔環的環徑需小于等于10 mil
接點密度需大于130點/平方英寸
布線密度大于117英寸/平方英寸
線寬/間距要3 mil/3 mil以下
主要特點是高密度性,其特征就是內部存在很多微盲孔/埋盲孔,因此其布線密度相比于傳統通孔板更高。
這是因為微盲孔/埋盲孔能夠節約布線空間。在普通多層板中,通過通孔連接不同層,但這些通孔會占用大量可用于布線的空間。
相反,利用微盲孔/埋盲孔來實現不同層之間的連接功能,可以釋放出更多的空間用于布線,從而提高了布線密度。
因此,隨著微盲孔/埋盲孔的增多,密度也隨之提高,換言之,HDI的階數越高,其密度也就越高。
一般HDI板基本上采用一次增層,高階HDI板則為二次或二次以上的增層技術,并同時使用電鍍填孔、疊孔、激光直接打孔等先進PCB技術,同時也有最高階的任意層高密度連接板(Any-layer HDI)技術。
基于 HDI 實際制造的難易程度和市場規模、發展趨勢,把 HDI 分為以下三大類:
入門類:一階 (1+C+1)、二階 (2+C+2)、三階 (3+C+3)
一般類:四階及以上、Any Layer (n+C+n,目前多為 10~12 層)
高階類:SLP(稱類載板)、軟硬結合板 (當中硬板部份使用 HDI工藝)
01HDI 一階
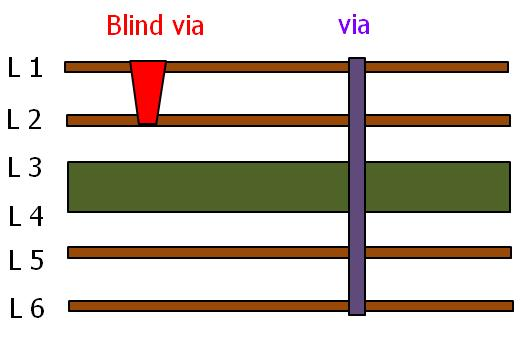
激光鉆孔 / 電鍍填孔:L1 - L2
02HDI 二階

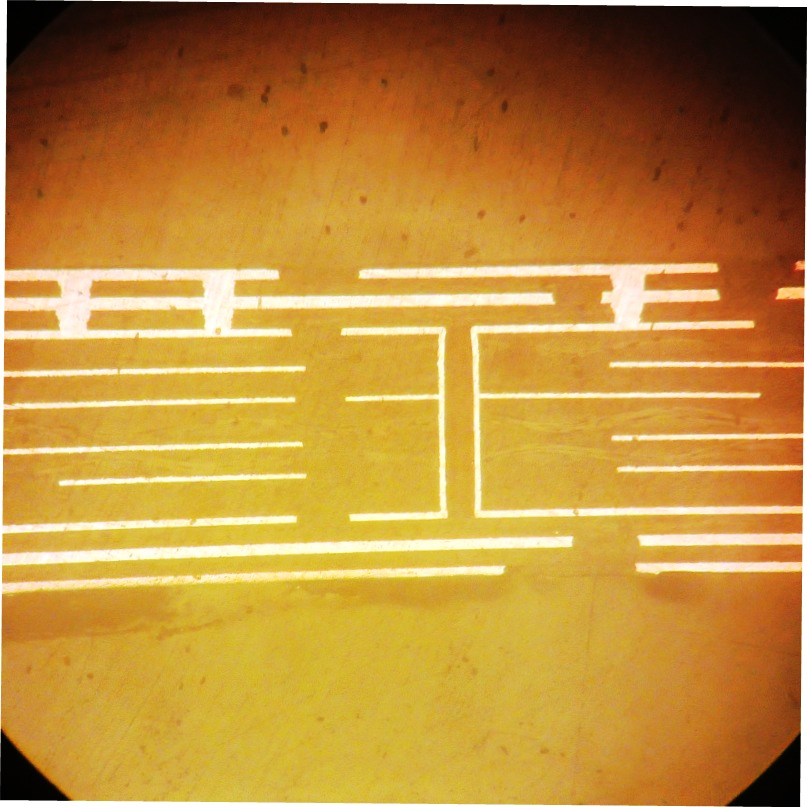
機械鉆孔 / 樹脂塞孔:L3-L8
激光鉆孔 / 電鍍填孔:L1-L2 / L9-L10 / L2-L3 / L8-L9
截面圖
03HDI 三階
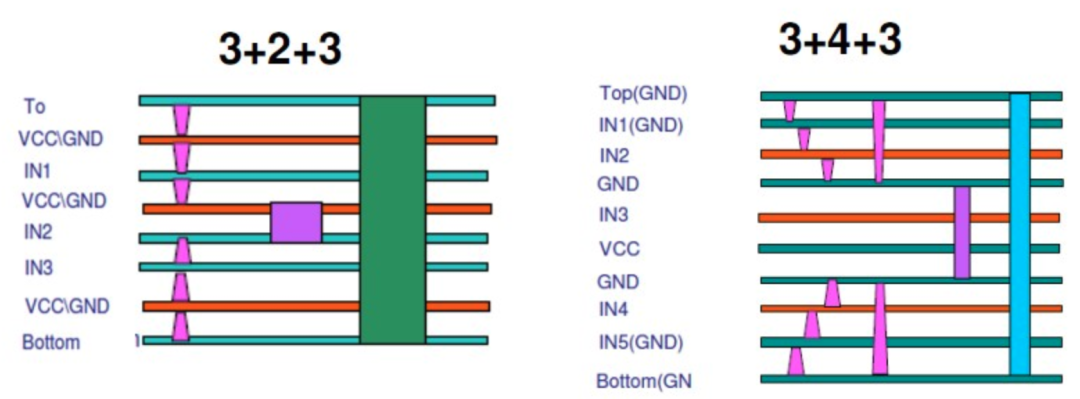
04Any-layer

任意層高密度連接板(Any-layer HDI)為高級HDI制程與一般HDI的區別在于,一般HDI是由鉆孔過程中的機械鉆直接貫穿PCB層與層之間的板層,而Any-layer HDI以激光鉆孔打通層與層之間的連通,中間的基材可省略使用銅箔基板,可以讓產品的厚度變得更輕薄,從HDI一階改用Any-layer HDI,可減少近四成左右的體積。
但需要注意的是,一旦HDI升級到任意層HDI,就無法再通過增加微盲孔/埋盲孔來進一步提高布線密度。
因此,在工業制造中,除了在HDI工藝基礎上增加微盲孔/埋盲孔外,還可以通過引入半加成法(mSAP)和載板工藝來制造更高密度的板材,即類載板(Substrate-like PCB,簡稱SLP)。
這表明HDI在實現高密度布線方面具有重要意義。
